技術・ソリューション
ケミカルクリーン技術
LSIのパターン寸法が0.5μm以下になると、LSIの品質はクリーンルームの浮遊微粒子の粒径と濃度の影響だけでなく、シリコン表面の原子レベルに影響するケミカル成分による汚染が歩留まりを左右します。これらの物質は浮遊微粒子より小さい、分子状・ガス状物質で、対策としてケミカルフィルタによる除去、水による吸着、発生する材料の選定などが行われています。
ケミカルガス対応湿式空調機 UCASS ユーキャス
乾式のケミカルフィルタは交換期間が短く、ランニングコストは非常に高価です。UCASSは滴下水膜方式により気中の分子状汚染物質AMC(アンモニア、二酸化硫黄など)を吸収、除去します。同時に気化式加湿が行われ、蒸気加湿に比べ省エネルギーとなります。
化学汚染物質の種類とデバイスへの影響例
| 化学汚染物質 | 発生源 | デバイスヘの影響例 |
|---|---|---|
| B(ボロン) | ● HEPA・ULPAフィルタ内のB2O3とHFの反応による | BF3は、イオン注入の際イオンソースとして用いられており、環境中に存在した場合デバイス特性や信頼性を捐なう。 |
| HF(フッ化水素) | ●ウェハーの洗浄工程 ●アッシングの際のフレオン(CF4)の添加による |
上記BF3の生成の原因となるウェハー上のアルミニウム配線が腐食し消失する。 |
| CI(塩素) | ● アルミニウム配線のドライエッチング用のBCI3、Cl2 | ウェハー上のアルミニウム配線が腐食し異物が形成される。 |
| NH3(アンモニア) | ● RCA洗浄工程 ● レジスト現像液 ●Si基盤とレジストとの接着促進剤 ●建材・コーキング材 |
化学増幅レジストで光により発生したH+が、アルカリ物質と接触することにより中和され、消失しバターン不良が発生する。 |
| SO4(硫酸基) | ●主に外気 ●ウェハーの洗浄工程 |
NH3と反応しSi表面にて(NH4)2• SO4を形成し、酸化工程においてSi基盤に積層欠陥が誘起されて、デバイス特性にダメージを与える。 |
| 低分子シロキサン | ●コーキング材 | Hazeと呼ばれる極微少表面突起の発生が促進される。 |
ケミカルフィルタ設置 実施例
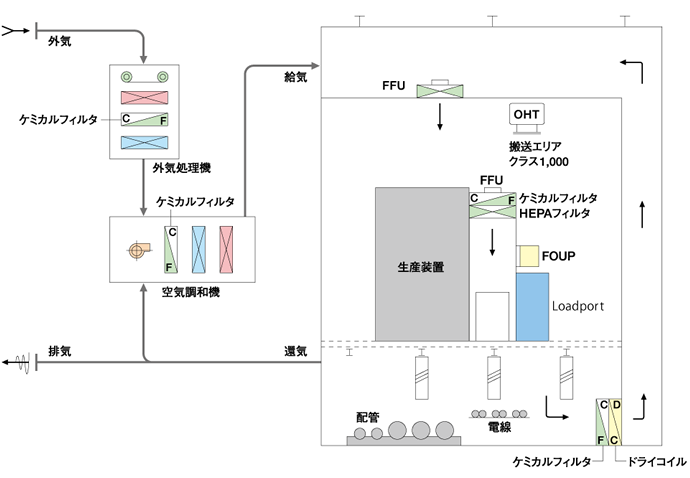
ケミカルガス対応湿式空調機(UCASS® :ユーキャス)

ケミカルガス対応湿式空調機
(UCASS®:ユーキャス)